技术分享丨浅谈SiP系列-常用软件工具篇(上)
 2022年7月12日 14:20
2022年7月12日 14:20EDA设计工具在SiP制造流程中占有举足轻重的地位,目前市面上最常见的SiP设计工具是Allegro Package Designer Plus和SiP Layout Option,其可实现2D 2.5D 3.D 等封装工艺中芯片,封装,无源器件在基板上的构建,叠构,设计,验证及生产文件生成。其简化了多个芯片集成在单个基板上的设计流程 。
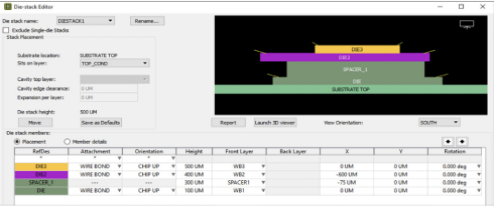


同时在SiP设计完成后,我们通常需要对SiP封装的电性能及热性能进行电热协同仿真,以保证封装产品的可靠性。Cadence针对封装SIP的仿真分析工具主要分为三大类:一是封装模型的提取、建模工具,二是信号完整性工具,第三类为电源完整性工具,具体如下:
模型提取
▶ XtractIM
XtractIM 是一款专门针对IC封装的宽带模型提取及封装性能评估工具。XtractIM能够生成标准的IBIS格式和SPICE子电路格式的封装模型。提取出的模型可以是各引脚或各网络的RLC网表,可以是带耦合参数的矩阵,也可以是Pi/T型SPICE子电路。XtractIM生成的模型可以用来评估封装模型电性能的好坏,也可用于系统级的SI和PI的仿真。
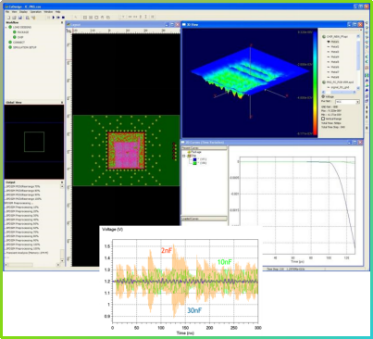
▶ XcitePI
XcitePI 是以芯片为中心的仿真和模型提取工具,可以用来设计和验证电源分配网络(PDN)和高速I/O。XcitePI可以提取芯片PDN模型和I/O互连模型。用户可以选择对部分结构或者整个芯片提取模型。模型提取考虑到整个芯片电源网格所有导体的寄生电阻,电容和电感的耦合。XcitePI提取的模型可以进一步用在系统级分析或者芯片-封装-PCB的协同设计。XcitePI还支持时域和频域的芯片PDN仿真,评估I/O电源地和信号的性能。
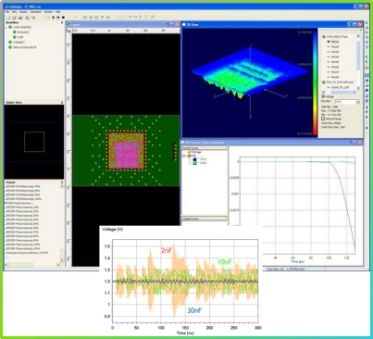
▶ PowerSI
PowerSI 可以为PCB和IC封装提供快速准确的通用频域电磁场分析,如S参数、Z参数的模型提取,空间模式下的噪声耦合分析,EMC/EMI分析,谐振模式分析,走线阻抗和耦合检查等。从而有助于解决高速电路设计中日益突出的各种PI和SI问题:如信号和电源网络布线质量的定量分析和耦合分析,电源平面的噪声分布和去耦电容的放置,封装的电磁辐射,封装结构中可能存在的谐振模式,以及走线的整体阻抗检查和耦合分析等。PowerSI可以在布局布线前用于创建PI和SI的布线规范,也可以在布局布线后用于发现或改善潜在的设计风险。
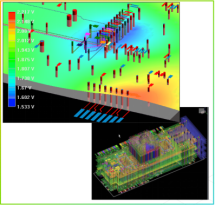
▶ Clarity
Clarity 3D 求解器是一款针对互联PCB,IC封装和系统集成封装设计的3D电磁(EM)仿真工具。Clarity 3D Solver可在设计5G,汽车,高性能计算(HPC)系统和具有高标准精度的机器学习应用程序时解决最复杂的电磁(EM)挑战。业界领先的Cadence分布式多处理技术使Clarity 3D解算器能够提供几乎无限的容量和10倍的速度,从而有效地解决更大、更复杂的结构问题。它创建了高度精确的S参数模型,用于信号完整性(SI),电源完整性(PI)和电磁兼容性(EMC)分析,使仿真结果与实验室测量相匹配。Clarity 3D Solver可以通过有效地将可用计算资源与设计大小相匹配来解决真正的3D结构。

信号完整性
▶ SystemSI Serial Link Analysis
SystemSI Serial Link Analysis 是专用于高速SerDes接口(如PCI-e, HDMI, SFP+, XAUI, Infiniband, SAS, SATA, USB等)进行系统级芯片到芯片验证的仿真工具。SystemSI-SLA时域、频域和统计分析相结合的技术确保高速串行互连分析的效率和仿真精度, SystemSI-SLA采用易用的模块化拓扑编辑系统网表,支持多种SPICE子电路模型(如IBIS, Device, Touchstone, BNP等),采用时域、频域和统计相结合的分析技术,通过进行无源通道频域响应分析、通道特性时域冲激分析、大容量数据码型的统计分析、误码率分析等,提取系统链路的统计眼图、浴盆曲线等特征参数,为串行链路系统性能评估提供依据。SystemSI-SLA支持各种领先的AMI/VMI模型,通过先进的串扰、抖动、噪声分析和灵活的参数扫描分析,并充分考虑信号反射、串扰、码间干扰、SSN等对信号质量的影响。

▶ SystemSI Parallel Bus Analysis
SystemSI Parallel Bus Analysis 是专门针对源同步高速并行总线接口(如DDRx)而开发的系统级芯片到芯片验证工具。SystemSI-PBA的前仿真能力(包括3D全波Via-wizard建模能力)确保精确的宽带模型能够快速产生并与其他系统模块连接。而后仿真能力允许用户加入优化的、包含更多细节信息的实际版图模型并进行最终的验证分析。所有的SI效应如导体/介质损耗、反射、ISI码间干扰、串扰以及同步翻转噪声(SSN)等都能在一个仿真引擎中同步考虑。其非理想电源仿真能力能精确模拟真实PDN噪声对信号的干扰。

电源完整性
▶ Celsius
Celsius Thermal Solver 是业内针对从集成电路到物理部件全电子系统所设计的一款完整电热协同仿真解决方案。Celsius Thermal Solver能够与Cadence IC、封装和基板设计平台实现无缝集成。利用创新的多物理场技术应对这些挑战。将实体结构有限元分析(FEA)与计算流体动力学(CFD)相结合,Celsius Thermal Solver可以在同一工具内完成系统分析。Celsius Thermal Solver帮助工程团队结合电气和热力分析,进行电力和热力流动仿真,从而获得比传统工具更精确的系统级热力仿真结果。此外,Celsius Thermal Solver基于先进3D 结构中电力的实际流动,执行静态(稳态)和动态(瞬态)电热协同仿真,提供了对真实世界系统行为的预见性。
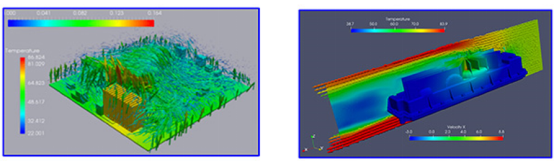
▶ PowerDC
PowerDC 能对IC封装提供快速准确的直流分析和电热协同分析,是一款能对基板和IC封装设计进行电热协同仿真分析的工具,其提供了一个详细的工作流程帮助仿真工程师发现设计中隐含的直流压降问题、电流密度问题和热可靠性问题。PowerDC能支持多Die堆叠的封装设计,能进行复杂设计的DRC检查,可以得到Die、过孔和封装等各组件的温度,还可以得到JEDEC定义的各种封装热参数模型。
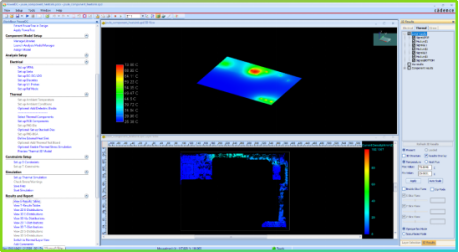
▶ OptimizePI
OptimizePI 应用Sigrity的电磁分析和优化算法可以使IC封装PDS网络的性能或成本达到最优。OptimizePI可以帮助设计人员自动地在合适的位置放置合适容值的去耦电容,来确保产品设计以最低的成本或最小的面积满足电源分配系统(PDS)的性能目标,优化电源平面谐振,或者在不增加电容种类的情况下实现最佳的PI、EMI性能。
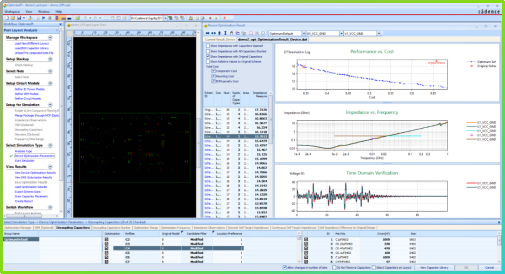
以上就是常见的设计及仿真工具,接下来会继续介绍质量管理、先进封装等章节,内容会持续更新,如想了解更多信息,请关注图元TOPBRAIN公众号,谢谢。

工程师必备
- 项目客服
- 培训客服
- 平台客服
TOP


















![[案例专题]基于ICEM和Fluent的二维喷管非结构网格算例实例](https://img.jishulink.com/cimage/a2935f5023ce0e9831b5db828f22c7f1.jpg?image_process=resize,fw_576,fh_320,)


